AOP-A-010
黏著促進劑
AOP-A-010主要由羥基硅烷組成。當採用旋塗方式塗佈於基材表面時,其羥硅醇基(–Si–OH)會與基材上的羥基(–OH)反應,形成穩定的Si–O共價鍵,如圖1所示。此反應取代了原有的親水性功能基,形成約15奈米的超薄硅烷偶聯層,顯著增強光阻與基材之間的化學黏著力。

AOP-A-010主要由羥基硅烷組成。當採用旋塗方式塗佈於基材表面時,其羥硅醇基(–Si–OH)會與基材上的羥基(–OH)反應,形成穩定的Si–O共價鍵,如圖1所示。此反應取代了原有的親水性功能基,形成約15奈米的超薄硅烷偶聯層,顯著增強光阻與基材之間的化學黏著力。


形成穩定的Si–O共價鍵,牢固結合基材表面,顯著提升光阻的黏著性能。

易溶於PGMEA顯影液,顯影後不留殘餘物,確保表面潔淨。

於150–180 °C熱退火處理後,處理層保持穩定,不干擾後續製程。

FTIR分析結果:
FTIR分析顯示治療前於3100–3600 cm⁻¹範圍內有明顯的羥基(–OH)吸收峰。
AOP-A-010處理後,此羥基吸收峰強度明顯減弱,
指示表面活性羥基減少,並成功形成Si–O化學鍵。
此結果證實光阻與基材間的黏著力有顯著提升。
此數據經由三輪內部實驗室測試驗證,基於紅外光譜分析,確保數據可信且具真實性。
隨著半導體製程不斷微縮並更加精密,光阻與基材之間的黏著力已成為影響微/奈米結構穩定性及整體製造良率的關鍵因素。作為應對此挑戰的關鍵材料,黏著促進劑在決定光刻工藝成功與最終器件長期可靠性方面扮演著決定性角色。
本報告對市場主流黏著促進劑產品進行了全面的比較分析,特別聚焦我們的創新方案—AOP-A-010。該產品突破傳統技術的限制,為次世代光刻應用提供卓越性能。
根據市場研究結果顯示,隨著半導體持續微縮、先進光刻需求增長,以及業界朝向永續與精密製造趨勢發展,高性能黏著促進劑市場持續快速成長。市場領先產品著重純度、提升黏著強度、與新型光阻的相容性及環境合規,而AOP-A-010則在這些方面樹立了新標竿。




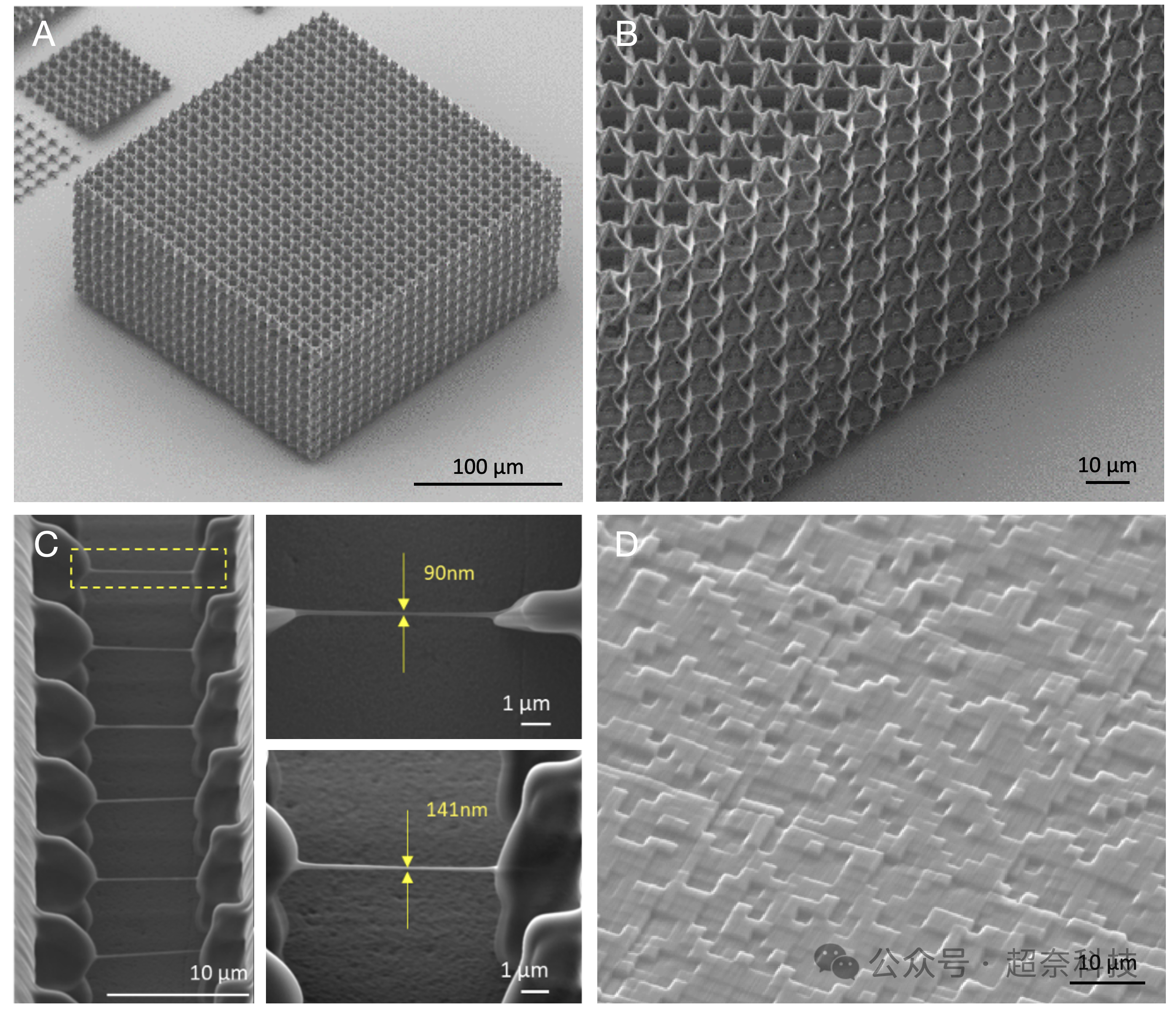
作用機制:基於AR 300-80技術,該配方加入專利表面能抑制劑,以提升界面性能。
主要優勢:
| 性能指標 | HMDS | TI PRIME | AR 300-80 | AOP-A-010 |
|---|---|---|---|---|
| 黏著工藝 | 發泡機+烤箱 (複雜) |
熱板/烤箱 (中等) |
熱板/烤箱 (中等) |
熱板 (簡易) |
| 化學毒性 | 有 | 低 | 無 | 無 |
| 適用光阻類型 | 僅正性 | 僅正性 | 正性/負性 | 正性/負性 |
| 抑制氣泡能力 | 無 | 無 | 無 | 有 |
| 製程相容性 | 傳統光刻 | 傳統光刻 | 傳統光刻 | 傳統光刻 + 雙光子光刻 |


Copyright © 2025 Astra Optics Limited